部落格
先進晶圓廠中的矽氧烷污染風險 PDMS 污染:標準超細纖維無塵布對良率的隱性衝擊
先進晶圓廠中的矽氧烷污染風險 PDMS 污染:標準超細纖維無塵布對良率的隱性衝擊
為何晶圓廠必須淘汰含矽成分的超細纖維擦拭布,以保護良率、光學元件與設備可靠性
Foamtec 技術白皮書 | 2025年12月10日
1. 執行摘要:被低估的矽氧烷威脅
多年來,半導體工程團隊一直致力於將矽氧烷(PDMS)從關鍵製程環境中徹底移除。這套防護策略十分成功,促使業界以 PFPE 取代矽油、以 FFKM 取代矽膠 O-ring,並全面停止使用 含矽潤滑脂,有效避免因逸散與轉移所造成的製程污染。
然而,許多晶圓廠忽略了另一個持續存在的 PDMS 污染源——超細纖維無塵布。實驗數據證實,不少亞洲來源的無塵布在製程中使用 PDMS 作為潤滑劑,清潔時極易殘留。PDMS 具有高度轉移性,一旦被帶入製程,便會造成嚴重的交互污染,影響前後段的各種先進製程,包括先進封裝。
業界已確認 PDMS 污染會導致:
1.前段(EUV / Metrology):光學霧化、量測飄移、靜電吸盤(ESC)不穩定
2.先進封裝:晶圓鍵合黏著失效、Underfill 可靠度下降、晶片與中介層貼附不良
Foamtec 的 MiraWIPE® 採完全無矽設計,驗證出具備「PDMS零檢出轉移」的能力,能有效封阻這條最難管控的污染途徑。
2. 產業前例:全面移除高轉移性矽氧烷污染源
半導體產業早已在真空系統與密封材料上推行「禁矽化」標準,這些成功經驗清楚顯示:面對高轉移性的污染物,唯有源頭移除,才能真正有效。

如今,同樣的標準必須應用到無塵布——這是無塵室環境中仍普遍存在、最後一個被忽略的矽氧烷來源。
3. 交互污染的源頭:晶圓背面成為 PDMS 儲存庫
含矽無塵布在 Track、濕式製程等非關鍵模組使用時,PDMS 會輕易轉移到晶圓搬運零件上,進而累積於晶圓背面,形成「PDMS 移動儲存庫」。
之後,晶圓進入高價值、高敏感度的設備時(例如 EUV、量測設備、蝕刻腔體),加熱或真空會使 PDMS 揮發、轉移、再冷凝於原本乾淨的表面。
也就是說:
即使設備使用無矽無塵布清潔,只要前段有 PDMS 污染源,就仍會被反覆汙染。
表 1:不同無塵布的 PDMS 含量與表面轉移數據

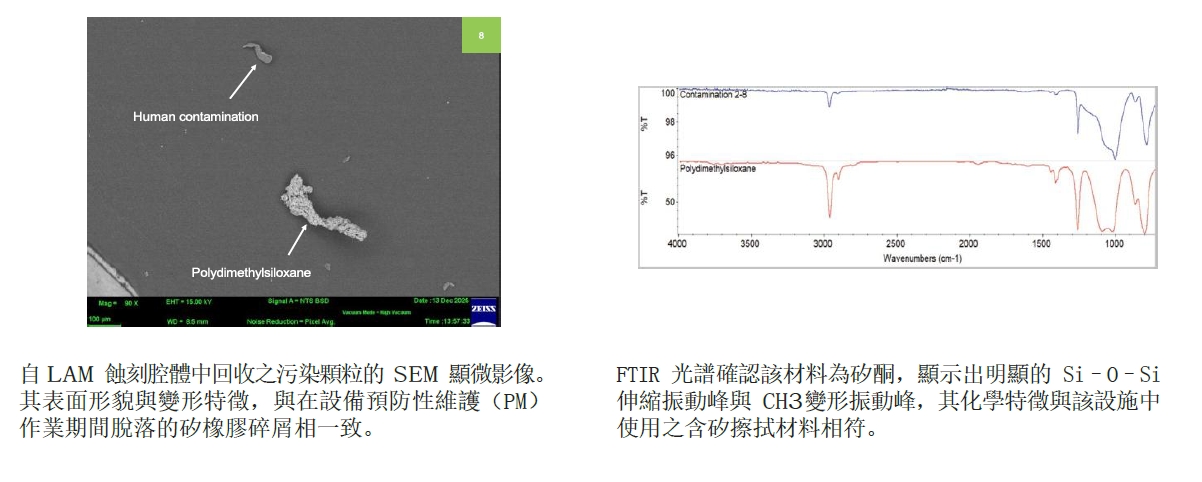
4. 對前段與先進封裝的關鍵影響
對前端和先進封裝的關鍵影響:即使是單層PDMS薄膜也會嚴重干擾邏輯電路製造和後端整合中的先進製程。
A.前段製程:對良率與設備穩定度的衝擊
1.光學霧化與量測飄移
PDMS 在 EUV 與量測光學元件上形成薄膜,造成光透率下降、CD 漂移、量測無法重現。
2.靜電吸盤(ESC)失效
PDMS 的非極性薄膜會降低摩擦力,造成晶圓滑移、熱分佈不均,使製程控制失準。
B.先進封裝:黏著的結構性失效
PDMS 是一種高效的脫模材料,會從根本上破壞了晶圓或晶片表面的高能黏附力。
1.W2W / D2W 鍵合失敗: 介面殘留 PDMS 會造成鍵合空洞、層間剝離與電性短路。
2.Chip-to-Interposer 鍵合品質下降: Underfill 與散熱材料(TIM)的附著力明顯降低。
3.RDL 形成與光阻黏著劣化: 影響 RDL 結構可靠度與光阻製程的一致性。
5.MiraWIPE®:從源頭杜絕 PDMS 污染
MiraWIPE 以「源頭移除」為核心設計理念,專為解決 PDMS 交互污染鏈而開發。
產品特點:
1.完全無矽設計(Fully Silicone-Free)
製程中不使用 PDMS、矽氧烷聚合物、矽基黏結材料或潤滑劑。
2.高效清潔性能
高微粒捕捉率、極佳耐磨性,非常適合用於關鍵作業環境中含有大量微粒的高負載需求。
6. 給晶圓廠工程師的建議
為確保良率並維持製程穩定性,以下行動可有效消除 PDMS 污染風險:
1.全廠統一控管
Track、Wet Bench、Etch、Ash、運輸模組等所有與晶圓接觸的區域,均需使用無矽無塵布。
2.材料稽核與汰換
建議使用分析工具檢驗現有無塵布,淘汰所有含 PDMS 的品項。
3.標準化材料
建議全廠統一使用 MiraWIPE®,徹底移除最後一個普遍存在的矽氧烷污染源。